


清空记录
历史记录
取消
清空记录
历史记录



TSV工艺
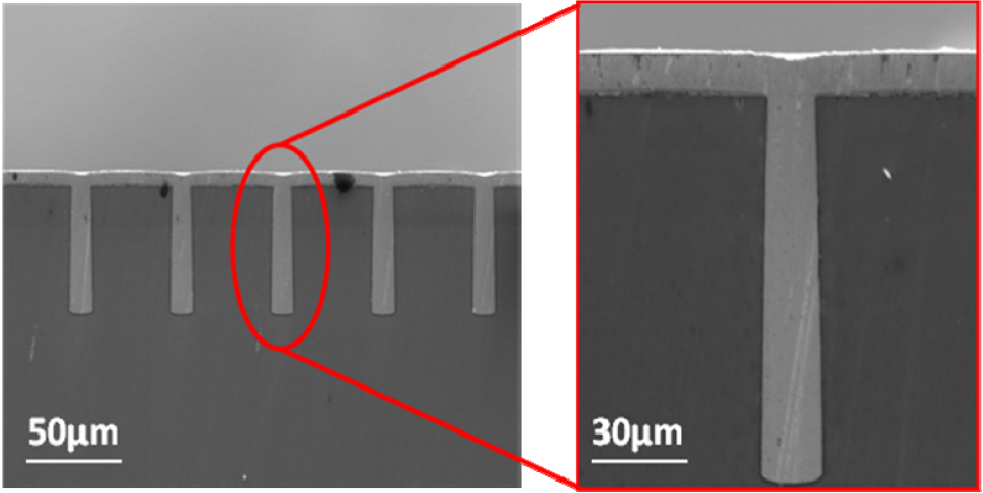
高深宽比TSV铜电镀填充结构
最大深宽比10,最小直径10μm,最大深度400μm
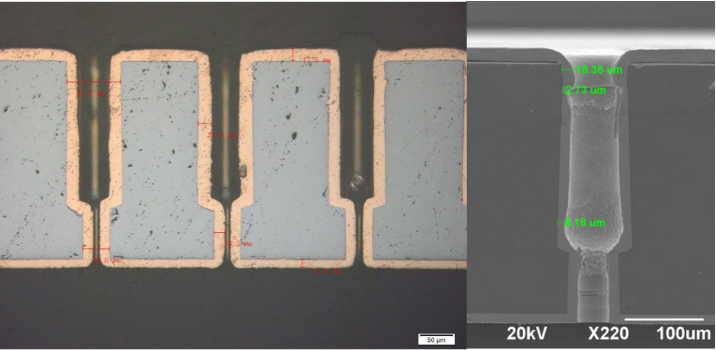
(a)通孔
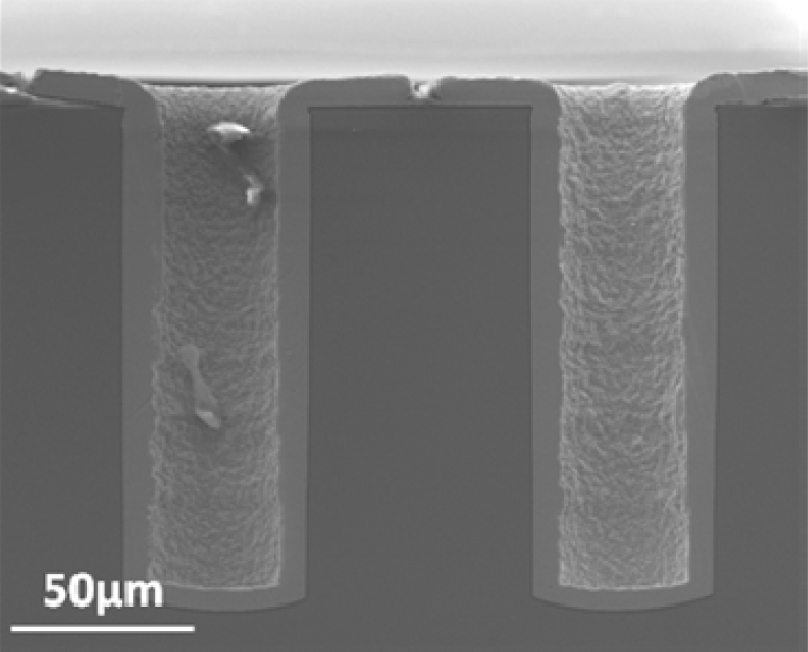
(b)通孔
环形TSV结构
环形TSV存在中空结构,有利于应力释放,降低封装;
相比全铜填充TSV,环形TSV射频性能更加优异,高频损耗更小
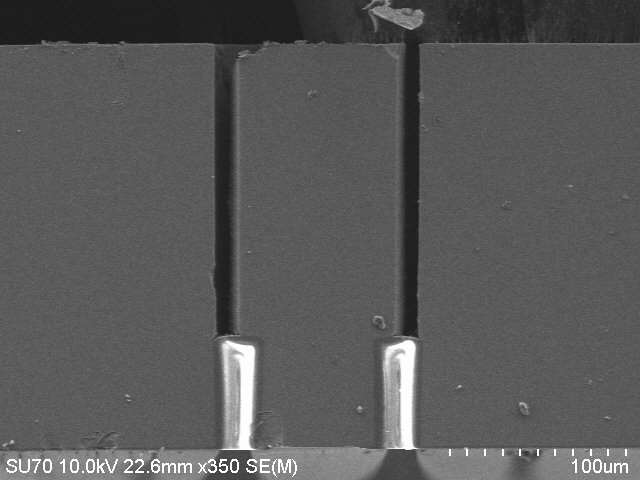
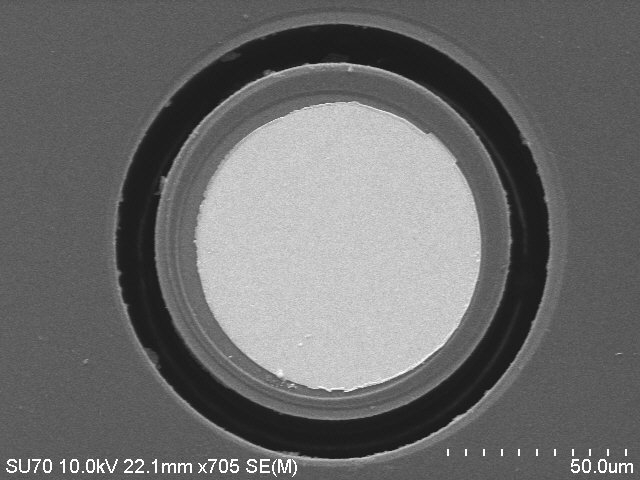
空气绝缘低阻硅TSV结构
通过自由端释放温度变化产生的应力,实现低应力封装单个TSV电阻率<1.52Ω
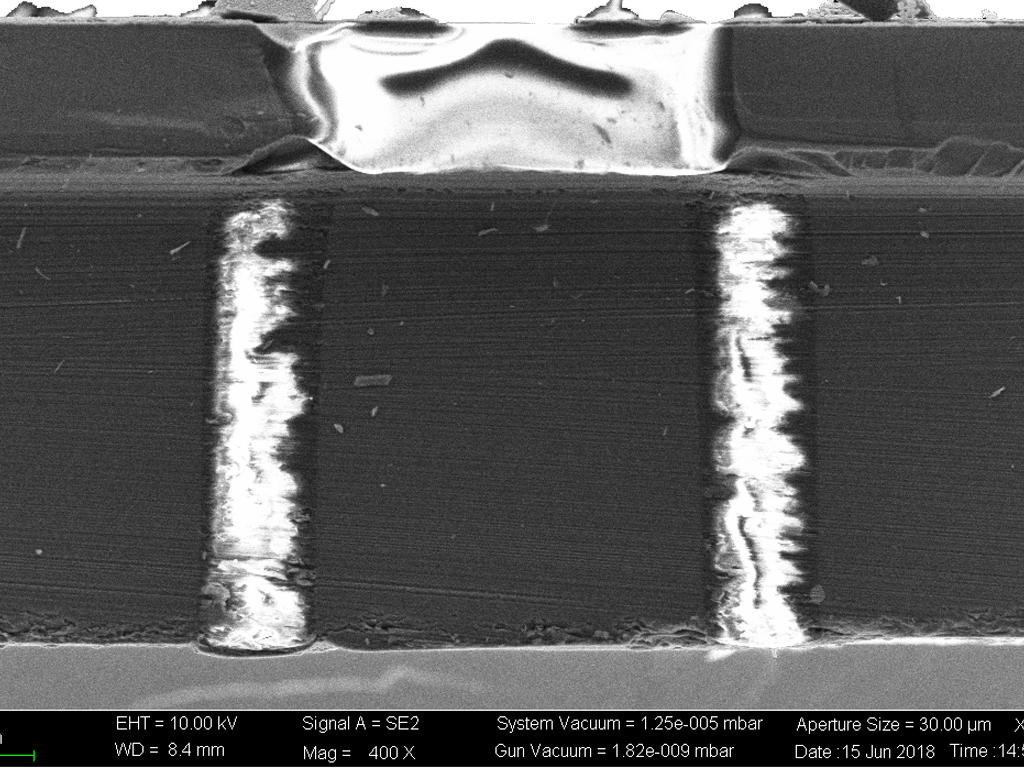
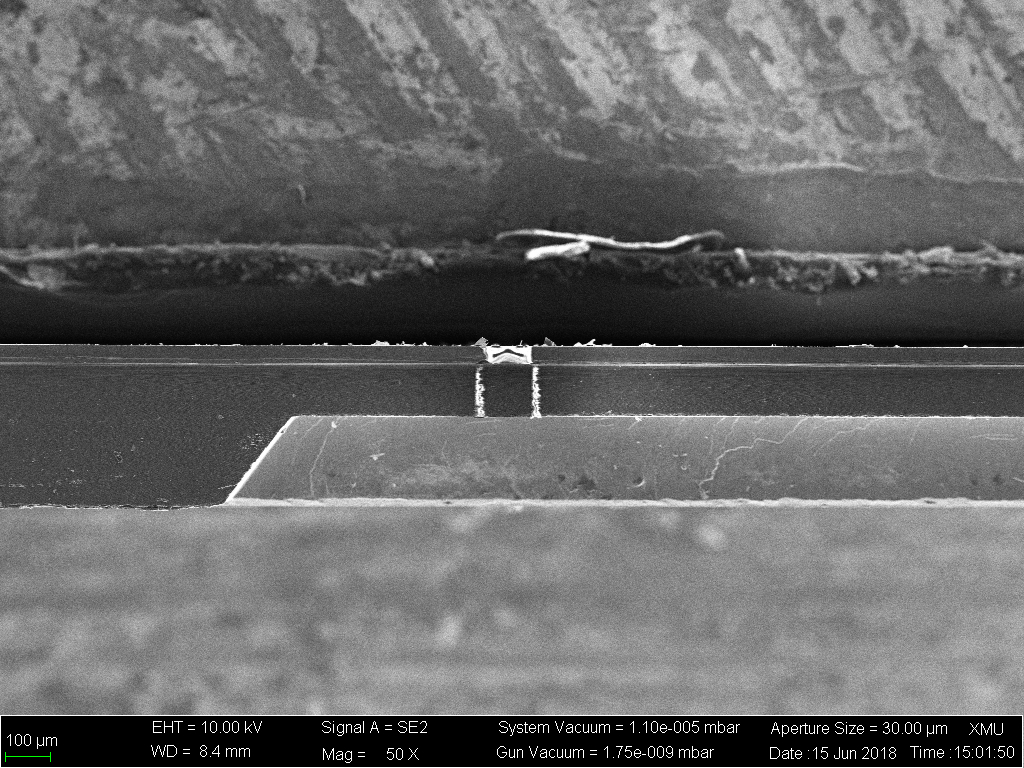
具有凹坑腔体的玻璃绝缘低阻硅TSI结构
存在与TSI连通的腔体结构,对于小芯片更易定位,垂直互连长度更短,避免大深宽比TSI的制造;
同时降低了封装体积。
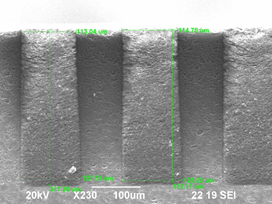
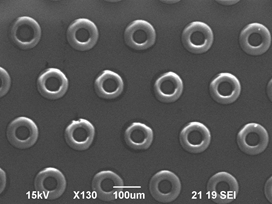
大尺寸高深宽比玻璃绝缘低阳TSI结构
通过玻璃浆料作为绝缘物填充,具有良好的绝缘性能和生物兼容性。
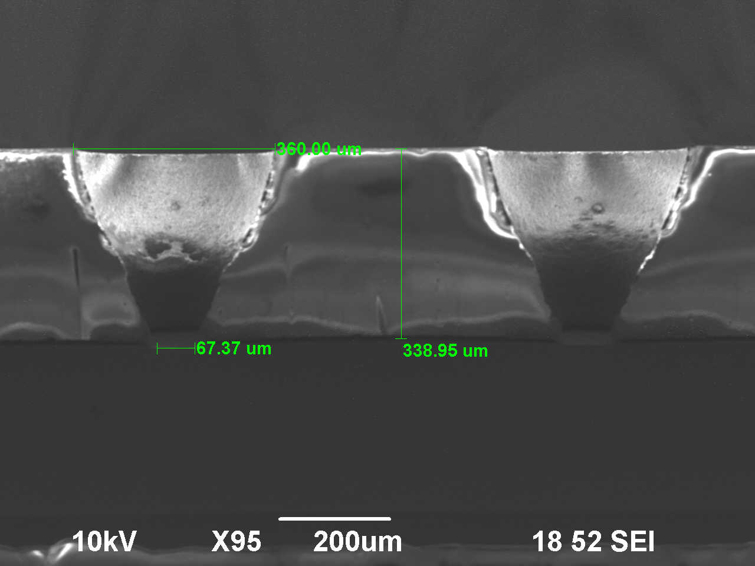
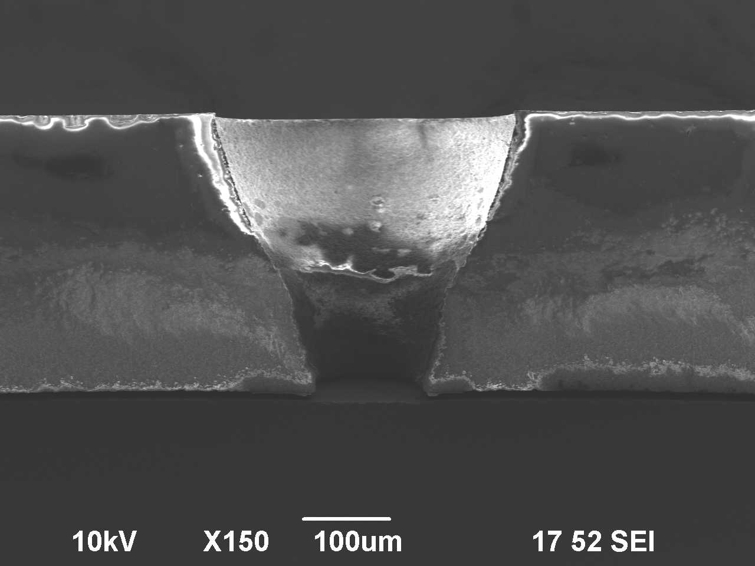
V形TGV结构
玻璃介电性能优异,信号传输完整性较好
CTE与硅接近,且易于加工
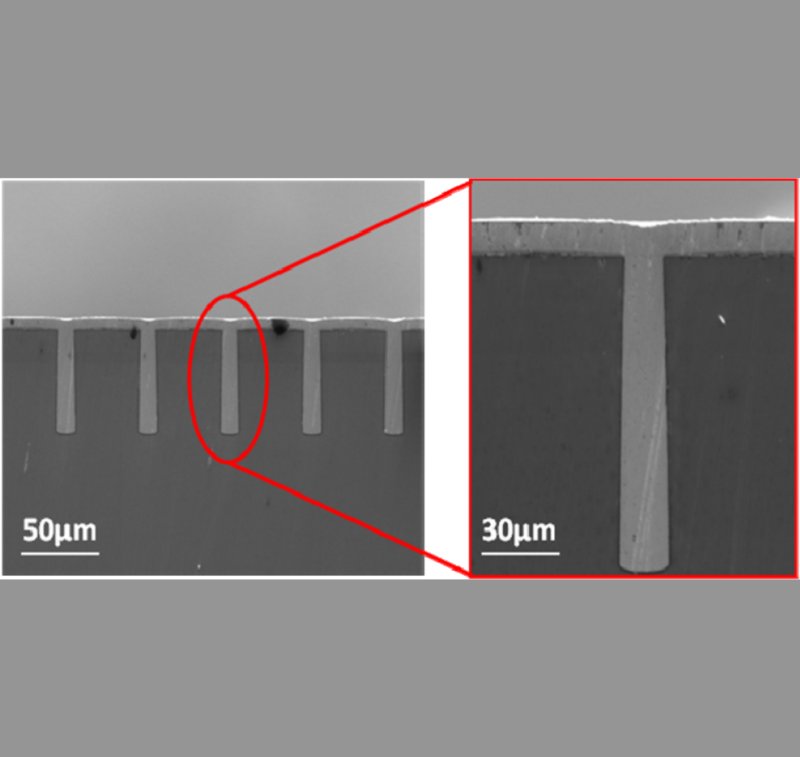
TSV工艺
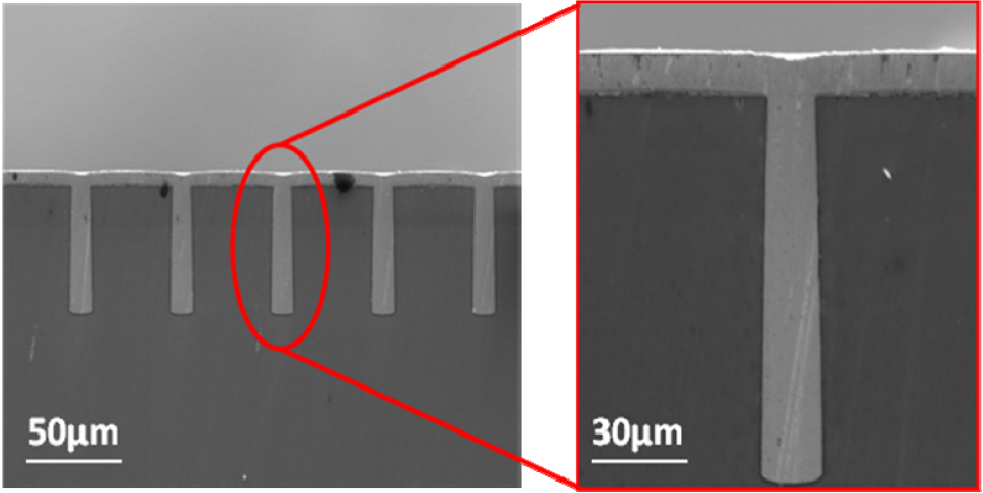
高深宽比TSV铜电镀填充结构
最大深宽比10,最小直径10μm,最大深度400μm
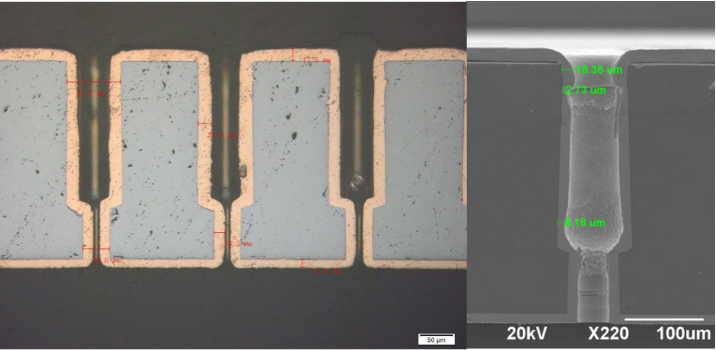
(a)通孔
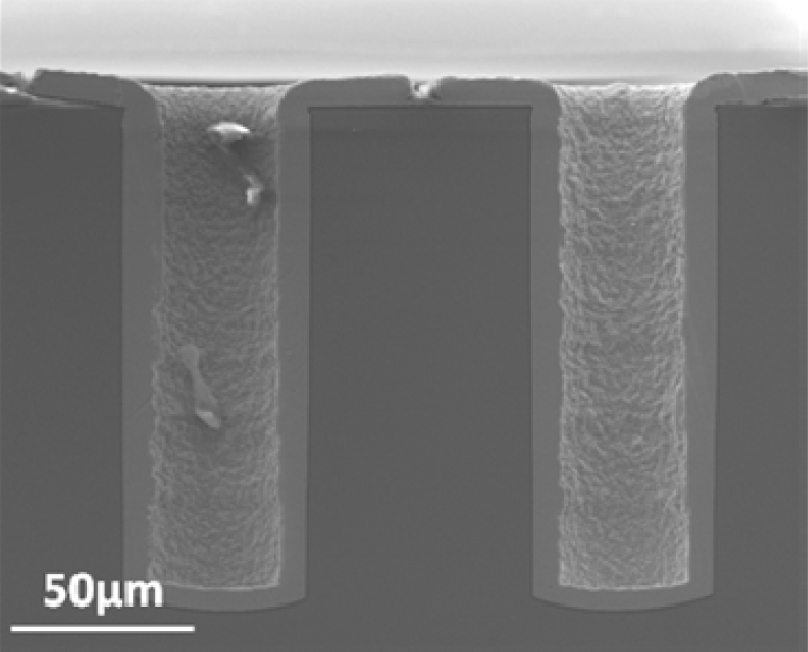
(b)通孔
环形TSV结构
环形TSV存在中空结构,有利于应力释放,降低封装;
相比全铜填充TSV,环形TSV射频性能更加优异,高频损耗更小
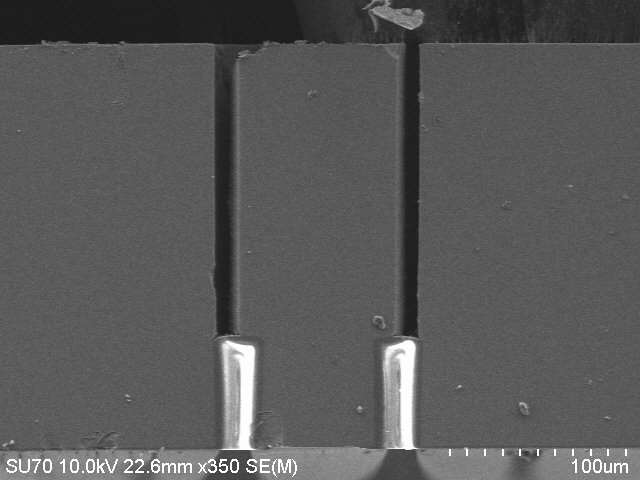
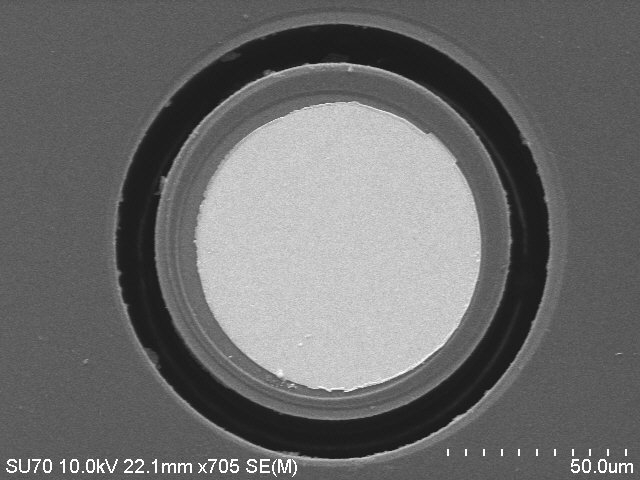
空气绝缘低阻硅TSV结构
通过自由端释放温度变化产生的应力,实现低应力封装单个TSV电阻率<1.52Ω
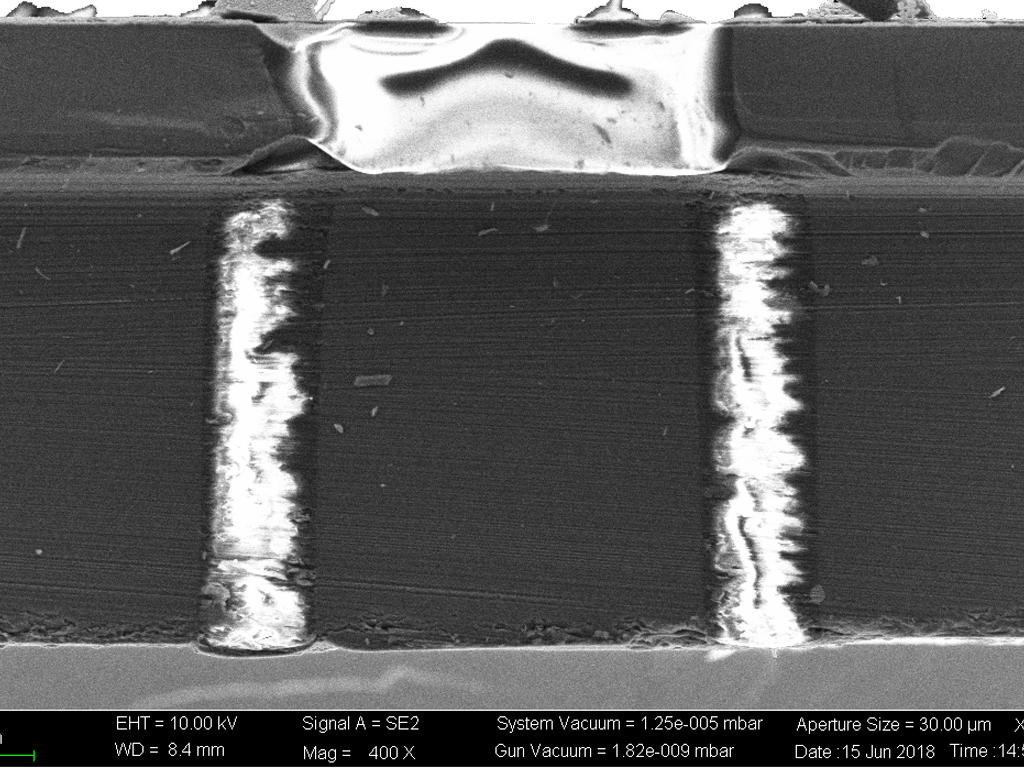
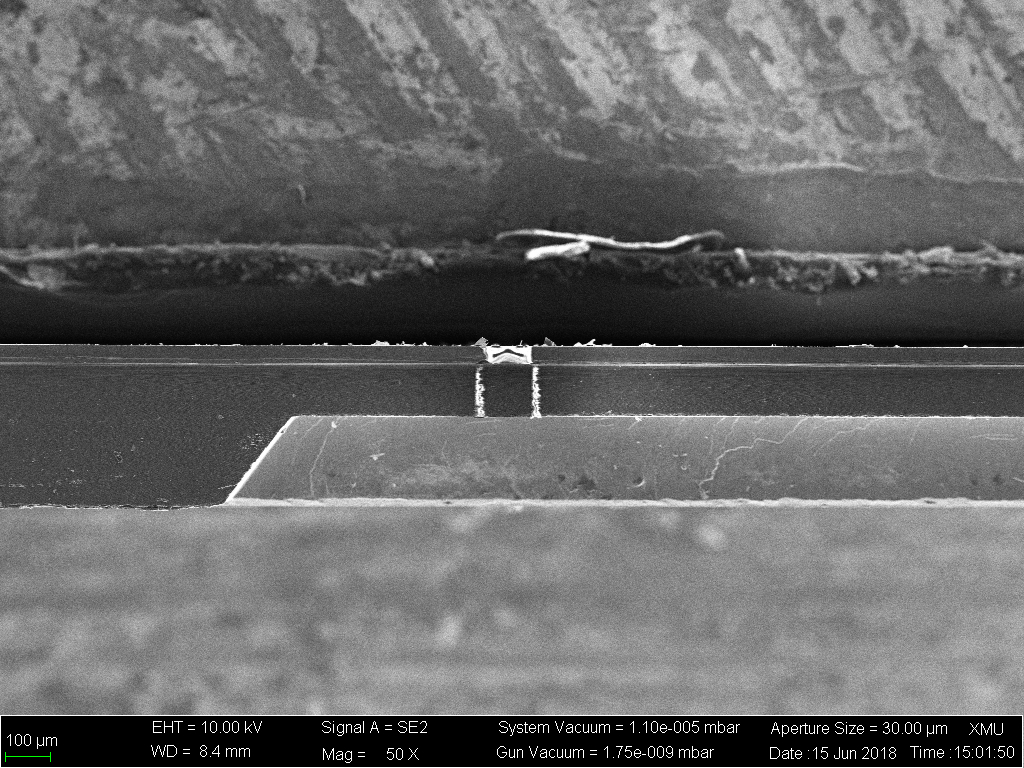
具有凹坑腔体的玻璃绝缘低阻硅TSI结构
存在与TSI连通的腔体结构,对于小芯片更易定位,垂直互连长度更短,避免大深宽比TSI的制造;
同时降低了封装体积。
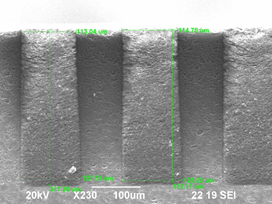
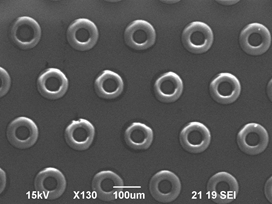
大尺寸高深宽比玻璃绝缘低阳TSI结构
通过玻璃浆料作为绝缘物填充,具有良好的绝缘性能和生物兼容性。
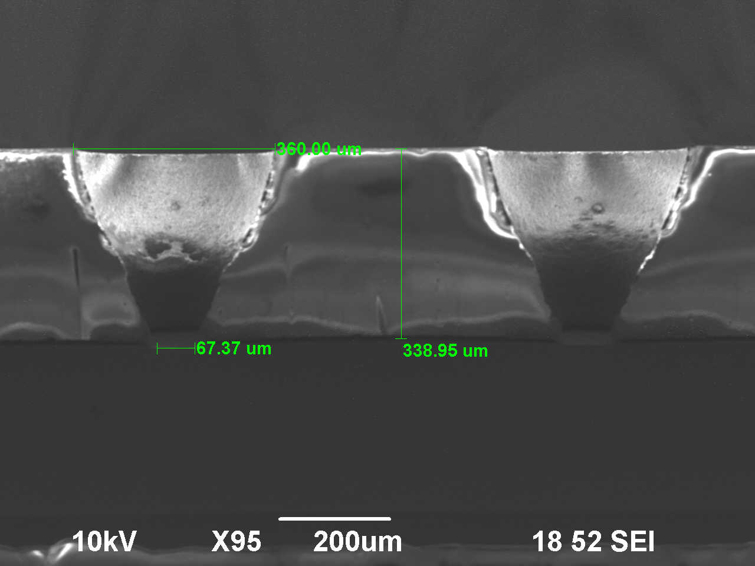
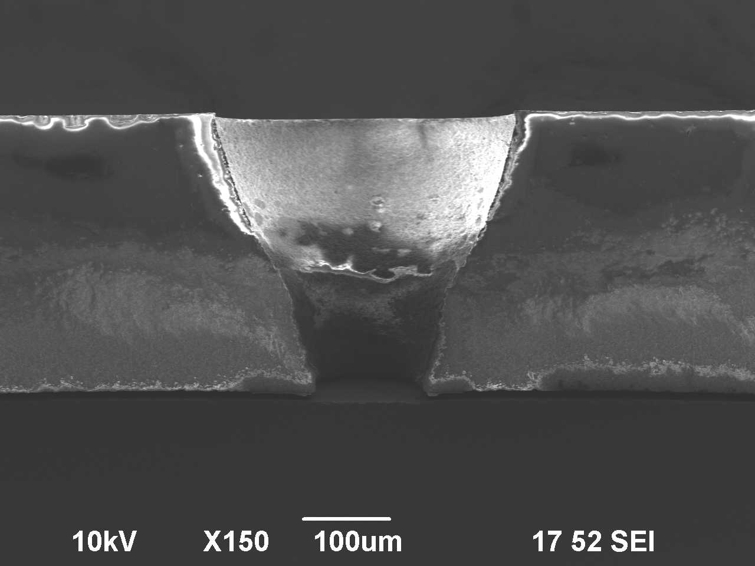
V形TGV结构
玻璃介电性能优异,信号传输完整性较好
CTE与硅接近,且易于加工


 浏览器自带分享功能也很好用哦~
浏览器自带分享功能也很好用哦~